- HOME >
- Search Products >
- Heat Curable SMT Adhesive >
- JU-R4S
JU-R4S
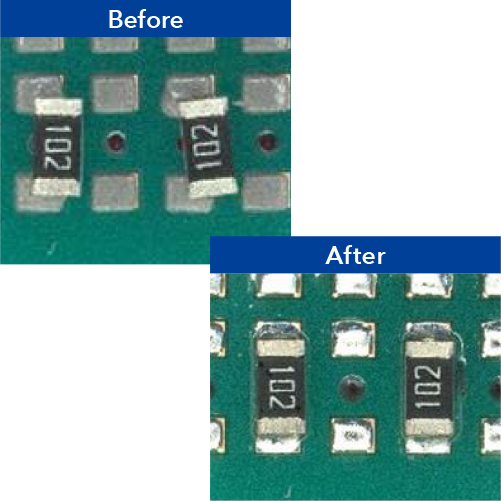
Best suited for keeping large
components from falling off
during double-sided reflow
Helps keep components on the board from
falling, shifting, or floating during reflow
Using a conventional adhesive with solder paste can result in the
lifting of components during reflow because the adhesive cures
before the solder paste melts. JU-R4S maintains its fluidity while
the solder is molten and facilitates setting of the components.

Allows solder paste
self-alignment at reflow
JU-R4S is designed to commence curing after the solder
(SAC305) has melted. Therefore, JU-R4S does not hinder
self-alignment of components that may occur when the
solder has melted.
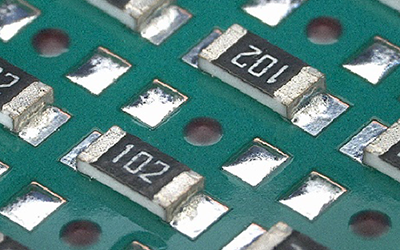
Stable dispense shape and superior electrical reliability after curing
Dispensability of JU-R4S was improved by reducing the viscosity
while shape retention was also improved by optimizing the TI value.
The resultant tall deposits ensure contact and adhesion even for tall components.
Nozzle: 19G single Dispense pressure: 350kPa Dispense time: 60msec
Clearance height: 280um Syringe temp.: 33℃
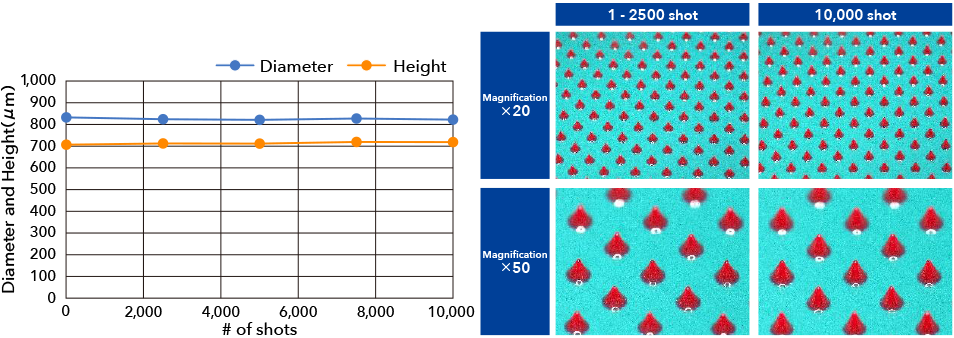
Product Performance Table
- Product Name
- JU-R4S
- Product Category
- Heat Curable SMT Adhesive
- Composition
- Epoxy resin
- State / Color
- Paste, red
- Viscosity(Pa.s)
- 50
- Tg(℃)
- 59.5℃
- Shelf life (0-10℃)
- 6 month
 Index
Index Domestic Bases
Domestic Bases Overseas Bases
Overseas Bases Sales Network
Sales Network Index
Index Message
Message Description of Business
Description of Business Overview
Overview History
History CSR
CSR